芯片粘接(Die Attach,DA)工艺指将芯片用有机胶和金属焊料粘接在基板上,起到热、电和机械连接的作用。目前拥有半自动和手动的有机胶和共晶焊料贴片能力。芯片粘接具体作用:使芯片和封装体之间产生牢靠的物理性连接;在芯片或封装体之间产生传导性或绝缘性的连接;提供热量的传导及对内部应力的缓冲吸收。
DA(Die Attach)或DB(Die Bond)又称装片,目的为将磨划切割好的芯片固定在框架Die Pad(芯片焊盘)或者Die Flag(芯片模旗)上以便后续工序作业,是封装的一个重要流程,影响整个芯片封装。芯片贴装(Die Attach)是封装工艺中非常关键的一步,其主要目的是将单颗芯片从已经切割好的Wafer上抓取下来并安置在基板对应的Die Flag上,利用银胶(Epoxy)把芯片和基板粘接起来如图7.7所示。因为IC本身属于精密的元件,胶粘剂对封装是否成功有很大的影响。有机胶根据需要可选择导电胶和导热胶两种,贴片机需具备点胶和放置芯片并提供压力的功能,有机胶固化工艺由所选胶本身决定。胶粘剂参数如表7.1、表7.2所示。
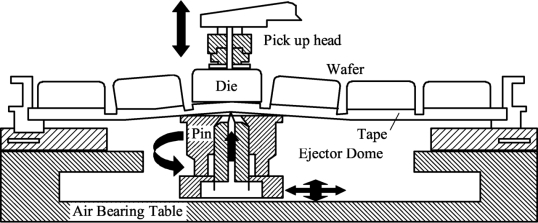
图7.7 芯片贴装机
表7.1 Au-Sn 共晶贴片工艺参数

表7.2 Au-Si 共晶贴片工艺参数

芯片粘接工艺目的是为实现芯片与底座(Chip Carrier)的连接,要求其机械强度高,化学性能稳定,导电、导热,热匹配,可操作性好。
芯片粘接拾取工艺过程:
(1)Ejector Pin从Wafer下方的Mylar顶起芯片,使之便于脱离蓝膜。
(2)Collect/Pick up head从上方吸起芯片,完成从Wafer 到L/F的运输过程。
(3)Collect以一定的力将芯片Bond在点有银浆的L/F的Pad上,具体位置可控。
(4)Bond Head Resolution:X-0.2 μm;Y-0.5 μm;Z-1.25 μm。
(5)Bond Head Speed:1.3 m/s。
芯片粘接工艺方法:(https://www.daowen.com)
1.共晶粘贴法
晶片背面健合形成共晶的粘贴方法。优点:金-硅共晶焊接机械强度高、热阻小、稳定性好、可靠性高、高温性能好、不脆化。缺点:生产效率低,不适应高速自动化生产。
2.焊接粘贴法
所用材料如下:
硬质焊料:金-硅、金-锡、金-锗(塑变应力高,抗疲劳抗潜变特性好);
软质焊料:铅-锡、铅-锡-铟;
所用气氛:热氮气;
工艺优点:热传导性好。
芯片焊接粘贴示意如图7.8所示。

图7.8 芯片焊接粘贴示意
3.导电胶粘贴法
导电胶粘贴法有三种导电胶:① 各向同性材料;② 导电硅橡胶;③ 各向异性导电聚合物。共同点是表面形成化学结合和导电功能。
4.玻璃胶粘贴法
该法类似于银浆粘接技术,主要用于陶瓷封装,需要严格控制烧结温度。优点是所得芯片封装无空隙、热稳定性优良、低结合应力以及湿气含量低;缺点为有机成分与溶剂必须除去,否则危害其可靠性。
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。






