芯片互连技术是将芯片直接与基板相连接的一种技术,主要包括引线键合(WB)、载带自动焊接(TAB)、倒装芯片技术(FCB)。芯片互连不仅作为芯片-基板间的电气互连形式,而且还作为一种微电子封装形式,常称为“零级”封装。从微电子封装今后的发展来看,将从有封装向少封装、无封装方向发展。而无封装就是通常的裸芯片,若将这种无封装的裸芯片用WB,TAB,FCB的芯片互连方式直接安装到基板上,即称为板上芯片(COB)和板上TAB或板上FCB,这些统称为直接芯片安装(DCA)技术,它将在今后的微电子封装中发挥更重要的作用。
1.引线键合技术
引线键合技术(Wire Bonding,WB)是将半导体裸芯片(Die)焊区与微电子封装的I/O引线或基板上的金属布线焊区(Pad)用金属细丝连接起来的工艺技术。工作原理:提供能量破坏被焊表面的氧化层和污染物,使焊区金属产生塑性变形,使得引线与被焊面紧密接触,达到原子间引力范围并导致界面间原子扩散而形成焊合点。焊区金属一般为AL或Au金属丝。多数是1 μm至数百微米直径的Au丝、AL丝和Si-AL丝。利用高纯度的金线(Au)、铜线(Cu)或铝线(Al)把Pad和Lead通过焊接的方法连接起来。Pad是芯片上电路的外接点,Lead是Lead Frame上的连接点。WB是封装工艺中最为关键最常用的工艺。引线键合3D视图如图7.9所示。
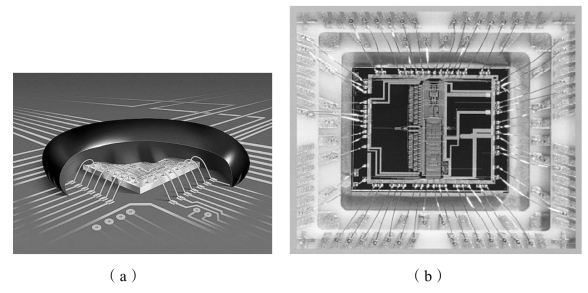
图7.9 引线键合3D视图
引线键合技术专业术语:
(1)Wire Bonding:引线焊接。
(2)Capillary:陶瓷劈刀。其为W/B工艺中最核心的一个Bonding Tool,内部为空心,中间穿上金线,并分别在芯片的Pad和Lead Frame的Lead上形成第一和第二焊点。陶瓷劈刀如图7.10所示。

图7.10 陶瓷劈刀
(3)EFO:打火杆。用于在形成第一焊点时的烧球。打火杆打火形成高温,将外露于Capillary前端的金线高温熔化成球形,以便在Pad上形成第一焊点(Bond Ball)。打火杆如图7.11所示。
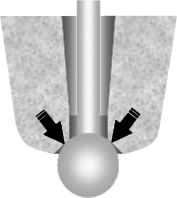
图7.11 打火杆
(4)Bond Ball:第一焊点。指金线在Cap的作用下,在Pad上形成的焊接点,一般为一个球形。
(5)Wedge:第二焊点。指金线在Cap的作用下,在Lead Frame上形成的焊接点,一般为月牙形(或者鱼尾形)。
WB四要素:压力(Force)、超声(USG Power)、时间(Time)、温度(Temperature)。
内穿金线,并且在EFO的作用下,高温烧球。
金线在Cap施加的一定压力和超声的作用下,形成Bond Ball,如图7.12所示。

图7.12 第一焊点(Bond Ball)
金线在Cap施加的一定压力作用下,形成Wedge,如图7.13所示。
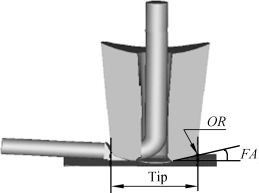 (https://www.daowen.com)
(https://www.daowen.com)
图7.13 第二焊点(Wedge)
WB的形成过程如图7.14所示。

图7.14 WB的形成过程
Wire Bond的质量控制形状如图7.15所示。
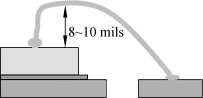
图7.15 Wire Bond的质量控制形状
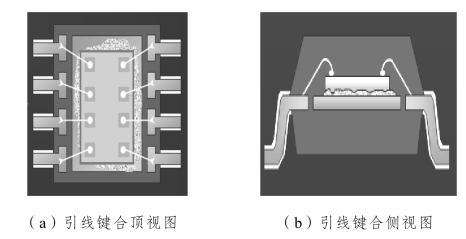
图7.16 WB封装成品的顶视和侧视
2.载带自动焊技术
载带自动焊(Tape Automated Bonding,TAB)技术是一种将芯片组装在金属化柔性高分子聚合物载带上的集成电路封装技术,将芯片焊区与电子封装体外壳的I/O或基板上的布线焊区用有引线图形金属箔丝连接,是芯片引脚框架的一种互连工艺。类似于电影胶片的柔性载带粘结金属薄片,柔性载带卷在一带卷上,载带宽度8~70 mm,在其特定的位置上开出一个窗口,窗口为蚀刻出一定的印刷线路图形的金属箔片(0.035 mm厚)。引线排从窗口伸出,并与载带相连,载带边上有供传输带用的齿轮孔。当载带卷转动时,载带依靠齿孔往前运动,使带上的窗口精确对准带下的芯片。再利用热压模将导线排精确键合到芯片上。TAB框架及过程如图7.17所示。
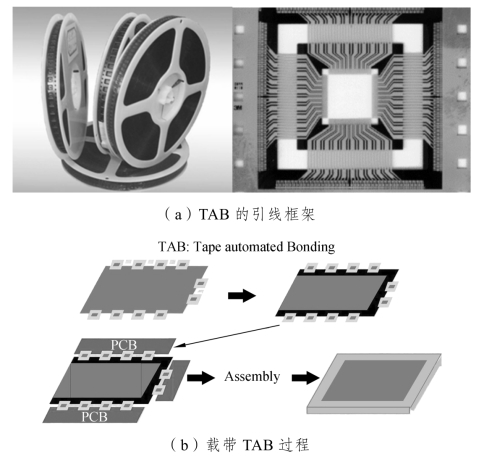
图7.17 TAB示意
TAB技术首先在高聚物上做好元件引脚的引线框架,然后将芯片按其键合区对应放在上面,最后通过热电极一次将所有的引线进行键合。TAB工艺主要是先在芯片上形成凸点,将芯片上的凸点同载带上的焊点通过引线压焊机自动地键合在一起,然后对芯片进行密封保护。
3.倒装芯片技术
倒装芯片技术(Flip Chip Boning,FCB)是芯片与基板直接安装互连的一种方法。在芯片连接的地方制作出突起的焊点,在后期操作中直接将芯片的焊点与基板的焊区形成连接。WB和TAB互连法通常是芯片面朝上安装互连,而FCB则是芯片面朝下,芯片上的焊区直接与基板上的焊区互连。FCB工艺如图7.18所示。
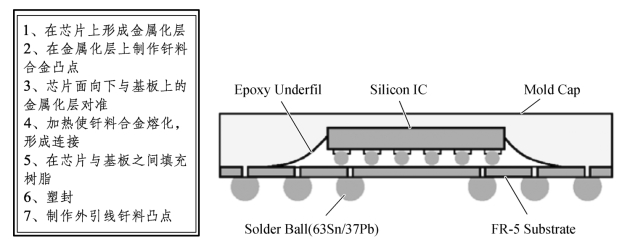
图7.18 FCB工艺
任务一学习成果评价

免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。





