9.2.2 常见辐射效应
卫星运行在空间辐射环境中,电子系统中的半导体器件受辐射粒子作用会产生总剂量效应(total ionizing dose,TID)、单粒子效应(single event effects,SEE)、充放电效应和位移损伤等。2001年,美国宇航公司统计了由空间环境效应造成的298颗卫星在轨故障原因,如图9-6所示,从图中可以看出,空间辐射带来的总剂量效应、单粒子效应、充放电效应等造成的卫星故障已超过环境诱发故障总数的78%。

图9-6 空间环境效应造成的卫星在轨异常原因分布统计
9.2.2.1 总剂量效应
总剂量效应是辐射效应的一种,是指器件主要受到高能质子、电子等辐射会造成与时间积累有关的辐射损伤的效应。不同种类的物质,其吸收辐射能量的能力不同,因此,针对半导体器件,早前使用总剂量单位为rad(Si),表示每克硅材料的物质上淀积100尔格(erg,1 erg=10-7J)的辐射能量。现在总剂量单位常用Gy标识,1 Gy=100 rad。
金属-氧化物半导体场效应晶体管(metal-oxide-semiconductor field-effect transistor,MOSFET)(简称“MOS器件”),也分为PMOS(P沟道型)管和NMOS(N沟道型)管,属于绝缘栅场效应管。其总剂量效应的物理过程是带电粒子(如电子、质子等)、X射线入射到MOS器件的氧化层时,会在氧化层中激发出电子空穴对。由于电子的迁移率比空穴的迁移率高得多,在电场的作用下,这些电子空穴对中一部分在氧化层中直接复合,另一部分电子被很快移出氧化层。相应地会有很多空穴留在氧化层中,留在氧化层中的这部分空穴会被氧化层陷阱所俘获形成氧化层陷阱电荷,而另一部分空穴在电场的作用下会移动到SiO2Si的界面处,被界面处陷阱俘获形成界面态陷阱电荷。氧化层陷阱电荷和界面态陷阱电荷的积累将会导致MOS管阈值电压的漂移及器件参数的变化,在空间辐射环境中虽然辐射剂量率非常低,但是随着陷阱电荷长时间的累积,MOS器件的性能也会不断降低甚至失效。总剂量效应在MOS器件的作用示意图如图9- 7所示。
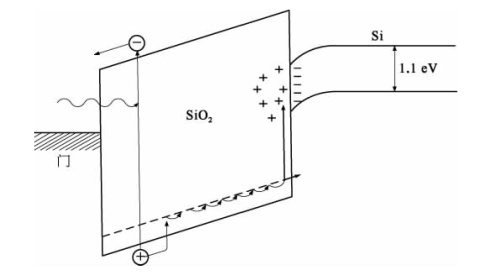
图9-7 总剂量效应在MOS器件的作用示意图
总剂量效应主要是在MOS结构的氧化层中引起。MOS器件的总剂量效应可以分为四个物理过程:电子空穴对的产生与复合、正电场下空穴的迁移、氧化物陷阱电荷的生成和界面处陷阱电荷的生成。具体如下:
(1)电子空穴对的产生与复合。总剂量辐射在SiO2材料中通过与原子核或核外电子相互作用而沉积能量,最终将转化为电子空穴对,然后产生的部分电子空穴对将很快发生复合,由于电子比空穴的迁移率高很多,通常在1 ps秒内电子就被扫出氧化层,向栅极运动并在那里复合掉。
(2)正电场下空穴的迁移。由于空穴的迁移率很低,未被复合的空穴在正电场的作用下向Si材料方向迁移,这个输运过程受许多变量的影响,主要包括氧化层厚度、栅极所加的电场、温度等。
(3)氧化物陷阱电荷的生成。当空穴迁移到Si-SiO2界面附近时,一部分会被氧化层陷阱所俘获,形成氧化层陷阱电荷。
(4)界面处陷阱电荷的生成。到达Si-SiO2界面的空穴将被界面态陷阱所俘获,在界面处造成不饱和键的积累,形成界面态陷阱电荷。
总剂量效应的结果就是在Si-SiO2界面附近的SiO2中形成氧化层陷阱电荷,同时在界面处形成界面态陷阱电荷。这将会使MOS管的阈值电压相应减小,沟道更容易开启,导致漏电流增加。Si-SiO2系统中的电荷与陷阱如图9- 8所示。

图9- 8 Si-SiO2系统中的电荷与陷阱
宇宙外层空间辐射对电子系统的影响主要是累积的剂量效应,绕地球运行的卫星受到的辐射主要来自范艾伦辐射带,飞行一年的累积照射量可高达2.6×103~2.6×104C·kg-1(在飞行体内部约低一个量级)。总剂量效应对器件最主要的影响就是阈值电压漂移,这主要是由于在空间辐射环境下,器件受到电子及带电粒子的照射,会产生电子空穴对,影响MOS器件结构中氧化层的电荷属性,从而产生器件阈值电压漂移。总剂量效应对NMOS和PMOS的影响不同,但总的阈值漂移都是负漂。
在电离辐射环境中,器件除了阈值电压漂移外,漏电流增加也是总剂量效应明显的特性。尤其NMOS管的阈值电压本来就相对较小,总剂量效应使得其阈值电压进一步减小,则NMOS管的亚阈值漏电将会非常明显。互补金属氧化物半导体(complementary metal oxide semiconductor,CMOS)器件漏电主要由栅氧漏电、场氧漏电及亚阈值漏电等几部分组成,由于NMOS管的阈值下降到接近0 V左右,此时的亚阈值漏电流非常明显,也是器件漏电流的主要部分。总剂量实验系统必须具有监测器件漏电流的能力。
9.2.2.2 单粒子效应
单粒子效应(single event effects,SEE)是一种突发性的粒子辐射效应,是指高能粒子(质子、重离子、α粒子等的能量>30 MeV)入射到半导体器件后,在粒子径迹上聚集的电荷量超过临界值,改变原有的工作状态,最终导致整个芯片或电路的宏观行为发生各种难以预料的变化。SEE过程中电荷的产生称为电荷沉积,产生电荷的总量称为沉积电荷。图9-9给出重离子电荷沉积的示意图,高能粒子射入靶材料后,能量被靶材料吸收,电子从价带跃迁至导带,同时留下空穴,最终导致轨迹上有大量电子空穴对产生。
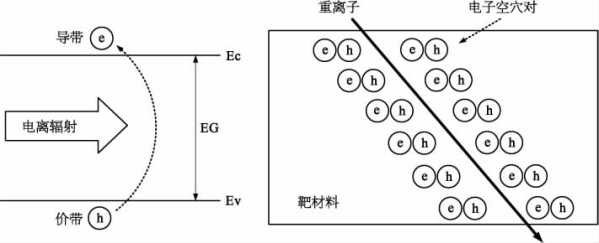
图9-9 重离子电荷沉积示意图
单粒子效应通常分为两类:一类是单粒子效应所引发的软错误,它并不会造成电路的损伤,而仅仅是在一定的时间段内改变了电路上原有的逻辑状态,这类故障是非永久的,如经常在组合电路中发生的单粒子瞬态(single event transient,SET)效应和在存储电路中发生的单粒子翻转(single event upset,SEU)效应等,其中,SEU是发生频率最高的软错误;另一类是单粒子效应所引发的硬错误,该类错误会造成器件或电路不可逆的永久损伤,例如单粒子栅穿(single event gate rupture,SEGR)效应、单粒子烧毁(single event burnout,SEB)效应、单粒子锁定(single event lock,SEL)效应等,其中,SEL是发生频率最高的硬错误。
SEB是一种破坏型的SEE,在NMOS管中极易发生。SEB通常由重离子辐射引发,但也可以在其他能够产生高瞬态电流的辐射源中触发。单粒子烧毁一般发生在具有寄生双极结型晶体管(bipolar junction transistor,BJT)结构的器件中,寄生BJT正向导通时器件内部瞬态电流急剧增大,最终导致器件烧毁是否触发由许多因素决定,其中最重要的影响因素是线性能量传输(linear energy transfer,LET)值、粒子入射轨迹和器件偏压条件。寄生NPN双极晶体管具有比寄生PNP双极晶体管更高的电流增益,所以N沟道型器件对SEB更为敏感。粒子入射和电离过程如图9-10所示。
SEGR是另一种破坏型的SEE,该效应只由重离子辐射源引起,并发生在功率MOS管关闭状态下。当一个重离子射入器件内部后,大量电子空穴对在栅氧化层下的硅体中产生,其中空穴在栅氧化层界面积累,栅氧绝缘介质上会产生一个极高的电场,如果栅氧绝缘介质发生击穿,SEGR就会被触发,导致器件永久性失效。如果栅氧漏电流增加幅度较小,就说明栅氧绝缘介质发生局部损坏,器件的基本性能会受到严重影响。如果栅氧击穿电流比正常栅漏电流高出几个数量,就说明栅氧绝缘介质受到严重损坏,导致器件发生灾难性损坏。
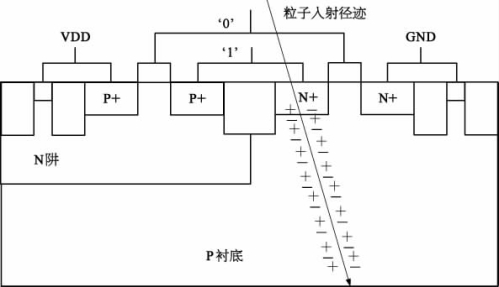
图9-10 粒子入射和电离过程
SEU是集成电路中最常见的SEE。SEU是指单个带电粒子(如高能重离子或质子)在集成电路中引起输入或输出节点逻辑状态翻转。快速转换的逻辑电路依赖时间和电流脉冲的精确控制,SEU可以导致数据频繁出现错误。器件和电路设计者并不能消除SEU引发的电流脉冲,但可以通过电路版图加固、工艺流程改进和逻辑纠错等方式消除对电路的影响。(https://www.daowen.com)
1)单粒子闩锁(SEL)效应
单粒子闩锁效应是指由于电路的输入端或输出端输入外来的噪声电压、电流,而导致寄生的双极型晶体管(也称“寄生可控硅”)形成闩锁导通,所引起的从电源到地之间流过大电流的现象,这种骤然增大的电流会使电路和器件无法正常工作甚至电路烧坏。P肼CMOS反向截面图如图9- 11所示。
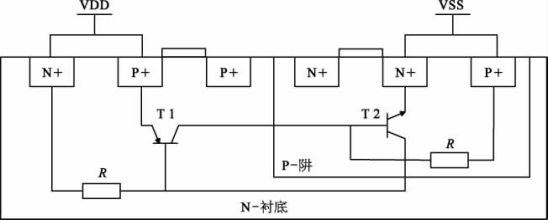
图9-11 P肼CMOS反向截面图
以图9-11为例,发生SEL的过程可分为四个步骤:
(1)空间高能粒子入射到CMOS器件并沉积在衬底或肼中。
(2)在器件中,沉积能量产生电子-空穴对,随着电子-空穴对的漂移和扩散产生微电流。若电流经过衬底或肼的电阻,则在电阻两端产生压降。
(3)由于任意一个晶体管的集电极与另一个晶体管的基极相连构成正反馈回路,正常情况下寄生可控硅处于高阻关断状态,若在第(2)步产生的压降使其中任意一个晶体管导通,则另一个晶体管也随之导通。
(4)此时寄生两个双极型晶体管都处于导通状态,并且两个晶体管增益的乘积大于1,由于寄生可控硅的正反馈效益,电流持续增大,等效于电源和地直接相连,发生闩锁效应。
对于CMOS器件而言,产生单粒子闩锁效应须具备如下三个条件:
条件一:寄生的两个双极型晶体管中任何一个发射极因外来干扰信号获得正偏,就有可能触发单粒子闩锁。
条件二:两个双极型晶体管的共发射极电流放大系数乘积大于1:
![]()
条件三:电源能提供的电流应大于或等于单粒子闩锁的维持电流。
单粒子闩锁效应的发生必须同时满足上述三个条件,缺一不可。CMOS电路中的寄生双极型晶体管闩锁模型如图9- 12所示。
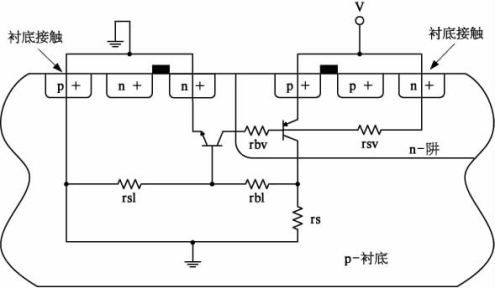
图9-12 CMOS电路中的寄生双极型晶体管闩锁模型
2)单粒子翻转(SEU)效应
单粒子翻转是指粒子撞击半导体器件,在运动径迹周围产生的电荷被灵敏电极收集,形成瞬态电流,使得存储节点状态发生变化导致存储电路发生翻转,从而产生错误,这种错误是软错误。高能带电粒子入射半导体材料之后,会使半导体材料电离,在其运动径迹上淀积电荷。电荷的淀积方式有两种:一种是通过入射重离子的直接电离,较轻的粒子如质子一般无法通过直接电离产生足够大的电荷使得存储电路发生翻转;另一种是轻离子如质子,它和半导体硅材料相互作用,产生次级带电粒子导致间接电离。当重离子入射到器件中,和半导体材料相互作用,发生弹性散射、非弹性散射、辐射俘获等。由间接电离产生次级带电粒子,在器件内部的运输过程中会在其运动轨迹周围产生电离能量沉积。
入射粒子对器件的损伤程度可以用现行能量传递LET来表示,LET表示的是单位长度上半导体材料沉积的能量,通常除以半导体材料的密度将其归一化。用公式可以表示为

式中,ρ为半导体材料的密度;d x为沿着粒子轨迹的直线距离;d E为粒子损失的能量;通常LET的单位是MeV·mg-1·cm-2。
在硅材料中由单粒子入射产生的电子-空穴对可以表示为

单粒子效应截面的定义如下:
![]()
式中,σ为单粒子效应截面(cm2);N为器件发生单粒子效应的次数;φ为单位面积的入射粒子数(cm-2)。单粒子效应截面越大,器件和电路的抗单粒子效应的能力越差。在试验中,可以通过测量翻转截面随有效LET值的变化情况来表示器件抗单粒子的能力。有效LET值定义为,粒子的LET值除以入射粒子的径迹方向与器件表面夹角的余弦值。翻转阈值定义为,当翻转截面迅速增大时对应的那个有效LET值。饱和截面定义为,随着有效LET值的增加,单粒子效应截面不再增加时的截面大小。
