10.2.2 片上系统与系统级封装
面向未来微纳卫星的发展,为了实现微纳卫星体积小、重量轻、功耗低、开发周期短、性价比高和功能密度高的研制要求,星载计算机逐步采用SoC技术与SiP技术,它们具有体积小、重量轻、功耗低、成本低和性能高的特点,是微纳卫星研制的关键技术。
1)SoC技术
片上系统(system on chip,SoC)从狭义角度讲,是信息系统核心的芯片集成,它是指将系统关键部件集成在一块芯片上;从广义角度讲,SoC是一个微小型系统,如果把处理器比喻成大脑,那么SoC就是类似大脑、心脏、眼睛和手的系统。
SoC所定义的基本内容主要包括构成和形成过程两个方面:一方面,SoC的构成类型主要包含微控制器、数字信号处理模块、控制逻辑模块、存储器模块、外部接口模块、电源管理模块、用户定义逻辑和基本软件模块等,并向用户提供软件载入接口等;另一方面,SoC形成过程主要包含集成系统的软件和硬件协同设计与验证、开发和研究IP核生成及复用技术、超深亚微米和纳米集成电路设计技术等。SoC系统级芯片如图10- 7所示。
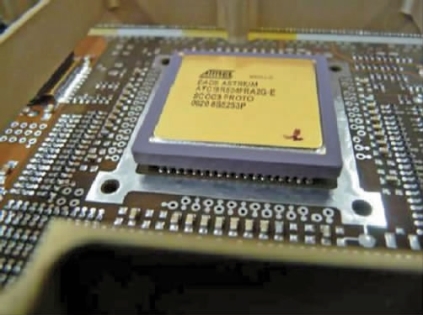
图10-7 SoC系统级芯片(https://www.daowen.com)
2)SiP技术
系统级封装(system in package,SiP),是指将多个具有不同功能的有源器件与无源元件组装成可以提供多种功能的单个标准封装件,构成一个系统或子系统,且出现故障后可进行维修的微小型化电路类产品。其不再用PCB板来作为承载芯片连接之间的载体,解决了因PCB自身先天不足所带来的系统性能遇到瓶颈的问题。从架构上来讲,SiP将处理器、存储器、ASIC电路、功能芯片和电阻电容等集成在一个封装内,组成一个基本完整的系统,该系统通常是面向用户的标准产品。SiP系统级芯片如图10- 8所示。
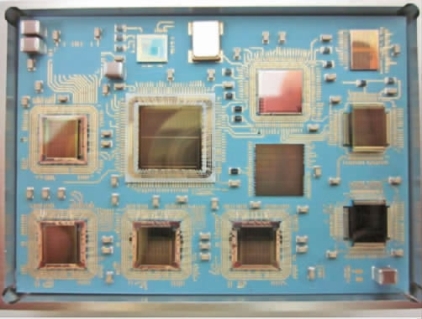
图10-8 SiP系统级芯片
SiP设计和生产过程包含分割(partitioning)与整合专有技术、覆晶技术、键合(wirebonding)技术、芯片多层堆叠技术、高密度黏结技术及最佳化的测试方法等技术。
SiP与SoC各有所长。SiP的优点是可实现高功能、开发周期短、低价格等。SoC的优点是低功耗、高性能、实装面积小等。两者互为促进,协同发展,都有利于进一步提升系统功能密度。两者之间又极为相似,均是将一个包含逻辑组件、内存组件甚至包含被动组件的系统,整合在一个单位中。SoC是从设计的角度出发,将系统所需的组件高度集成到一块芯片上。SiP是从封装的立场出发,对不同芯片进行并排或叠加的封装。在电子产品体积、性能等各方面需求的牵引下,SoC曾经被确立为未来电子产品设计的关键与发展方向,但随着近年来生产成本越来越高,SoC频频遭遇技术障碍,造成其发展面临瓶颈,进而使SiP的发展越来越被业界重视。
